Product Overview
MICROFAB TS-650 NXG Tin Silver bump plating bath is an organic sulfonate-based electrolyte, for high speed electro-deposition of smooth fine-grained, uniform Tin Silver alloy bumps. It is designed for lead-free and capping applications and provides exceptional within-wafer (WIW), within-die (WID), and within-feature uniformity.
Features
- Low temp solder
- Low alpha
- Smooth deposit
- Excellent coplanarity
- Low surface roughness
- High speed
For consultation with one of our experts and access to detailed technical data , please fill out and submit the contact us form.
MICROFAB TS-650 NXG Sales Sheet English
Designed for a wide range of Flip Chip, FOWLP, 2.5D/3D bumping applications.
MICROFAB TS-650 NXG is designed for a wide range of Flip Chip, FOWLP, 2.5D/3D bumping applications with higher plating speeds. It is a MSA- Based Tin Silver process combined with a three-part additive system.
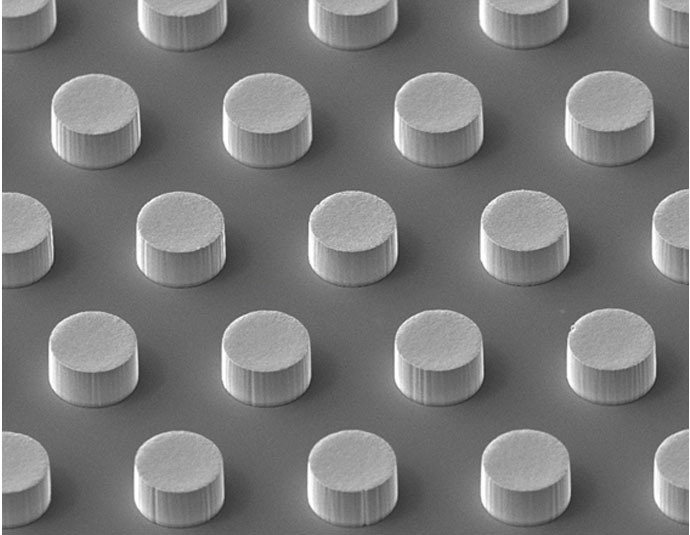

Designed for C4 Bump (Mushroom, In-Via), mBump and capping applications
MICROFAB TS-650 NXG is designed for C4 Bump (Mushroom, In-Via), mBump and capping applications. MICROFAB TS-650 NXG has a smooth as plated deposit morphology, excellent Ag% control and uniformity.
Excellent WID / WIW Height Uniformity.
MICROFAB TS-650 NXG is void free post reflow and has excellent WID / WIW height uniformity. It exhibits high stability and resist compatibility with a wide process window allowing deposition rates of 6 -15 ASD.

MICROFAB TS-650 NXG
|
Product Name |
Solder Type |
Surface Type |
Peformance Feature |
EHS |
|---|---|---|---|---|
|
MICROFAB TS-650 NXG |
Sn/Ag – Tin Silver |
Smooth Deposit |
Hybrid CD leveling |
Lead-Free |
